随着封装结构越来越小型化,我们越来越需要仔细评估芯片封装结构的散热效应,对于产品可靠性的影响。以及相关热应力对于芯片性能的影响。设计出合理的散热封装结构可以有效的提高产品性能,本文以常见BGA封装结构为例,采用ANSYS稳态散热对封装结构进行分析。虽然模型很简单,但是对于封装结构的优化设计很有帮助。
一、模型
BGA的模型主要有芯片,基板,EMC,焊球,粘结层等组成,在建模的时候,我省略了一部分。
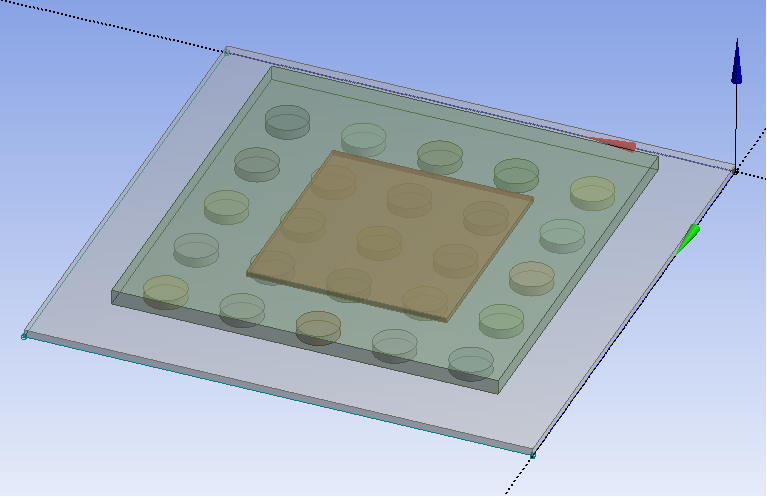
二、因主要考虑稳态的散热问题,计算量不大,因此可以采用全模型进行分析。
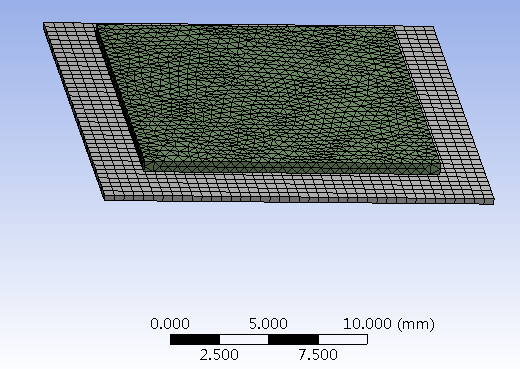
三、对以上各层材料都赋予材料参数,热导率可由材料供应商出获得;
四、热源主要为芯片产生的热,可以根据功率和芯片面积进行换算。本例子中,芯片的热生产率设定为0.075w/mm^2;
五、热对流换热系数设定为2e-4 w/(mm^2*K)
六、模型外面还会通过辐射进行散热,可以设定底部或者上部材料的黑度值为0.9;
七、环境温度设置为22C;
八、计算的结果如下:
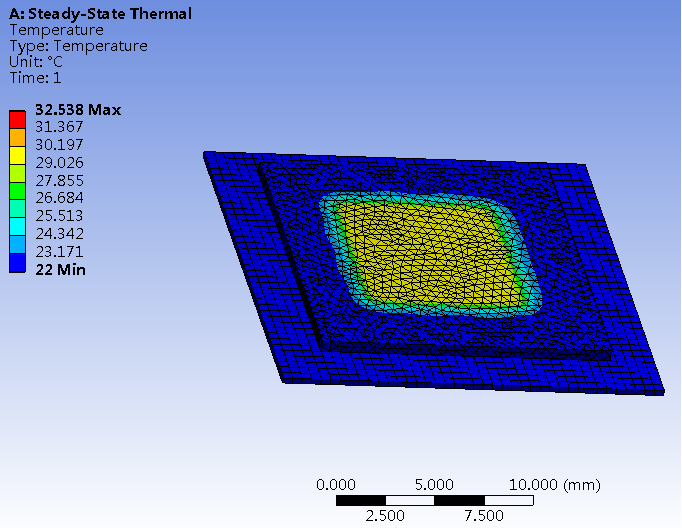
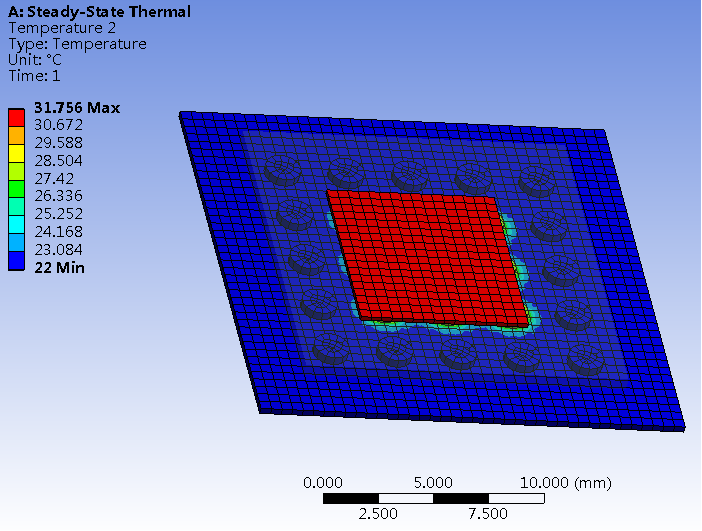
可以看出,在该工作功率下,芯片的温升仅为31C。
免责声明:本文系网络转载或改编,未找到原创作者,版权归原作者所有。如涉及版权,请联系删
武汉格发信息技术有限公司,格发许可优化管理系统可以帮你评估贵公司软件许可的真实需求,再低成本合规性管理软件许可,帮助贵司提高软件投资回报率,为软件采购、使用提供科学决策依据。支持的软件有: CAD,CAE,PDM,PLM,Catia,Ugnx, AutoCAD, Pro/E, Solidworks ,Hyperworks, Protel,CAXA,OpenWorks LandMark,MATLAB,Enovia,Winchill,TeamCenter,MathCAD,Ansys, Abaqus,ls-dyna, Fluent, MSC,Bentley,License,UG,ug,catia,Dassault Systèmes,AutoDesk,Altair,autocad,PTC,SolidWorks,Ansys,Siemens PLM Software,Paradigm,Mathworks,Borland,AVEVA,ESRI,hP,Solibri,Progman,Leica,Cadence,IBM,SIMULIA,Citrix,Sybase,Schlumberger,MSC Products...