散热设计十分重要
热失效的表现:炸毁、炸机
l 截流不够而烧毁
l 风道设计不良而烧毁
可靠性问题
:油井测井一起的工作环境:高温+高湿度+撞击

理论性和经验分析、实验的局限性比较强
09:05
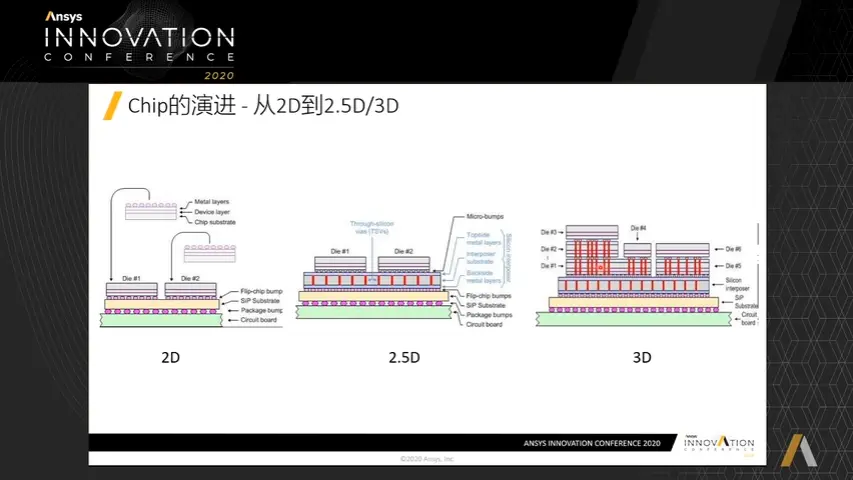
目前主流是2D封装,2.5D和3D封装
非常注重到散热的设计。
2.5D的温度上升幅度很大,

icepeak具有全尺度的热仿真能力

最主要的能力:多物理场愈合能力
mechanical进行热应力、热分析,疲劳的分析
sherlock可靠性分析
simplorer系统级别的长路混合仿真

STM模型:芯片热模型
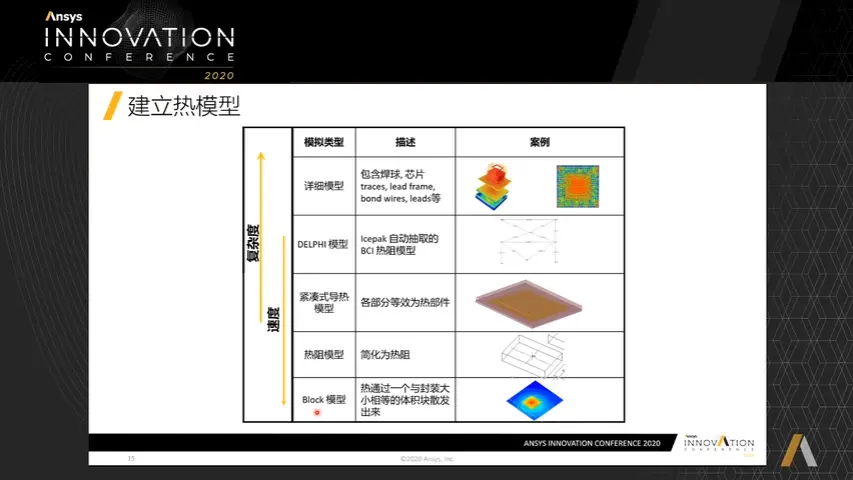
block最简单的模型
详细模型的精度是最高的(EDA软件)
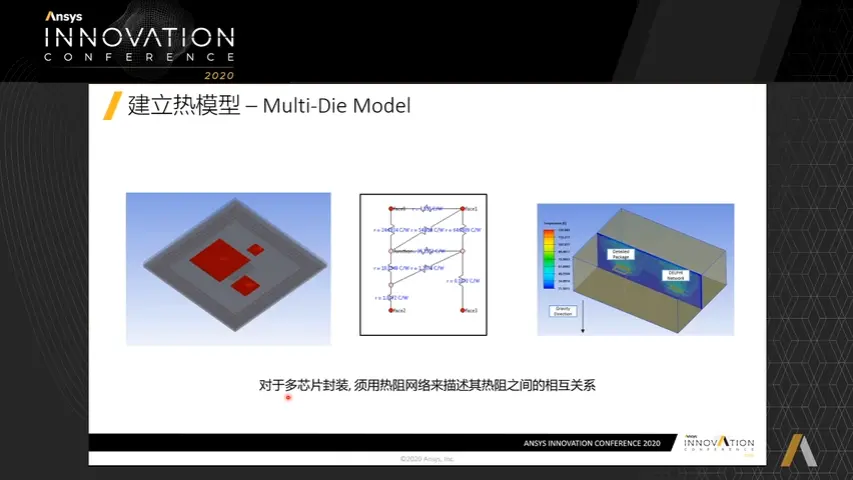
多个Die模型

可以用仿真的手段去搭建起JEDEC的仿真环境
提取热阻出来
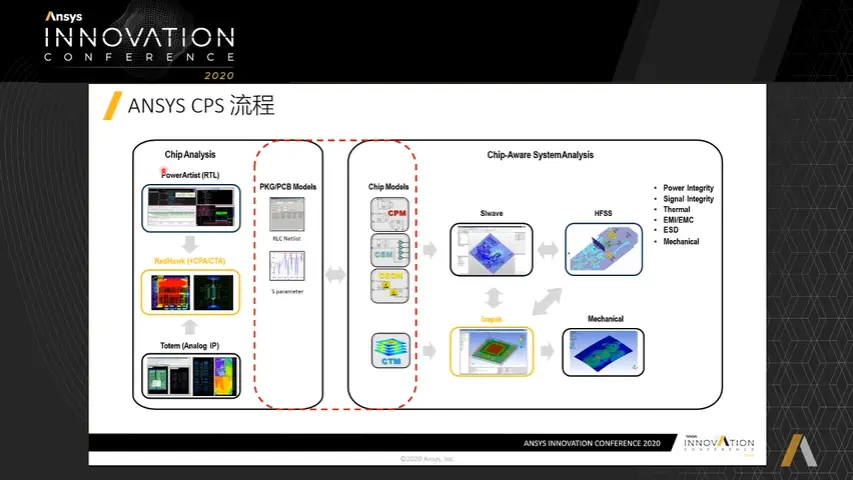
左边三个是芯片设计人员使用的
芯片设计要考虑系统的影响
可以使用的slave来把系统抽取出模型PKG\PCB
用这些模型用slwave这些工具进行协同仿真

左边是封装,
功率密度和温度也是相对应的
在基板上可以产生焦耳热效应
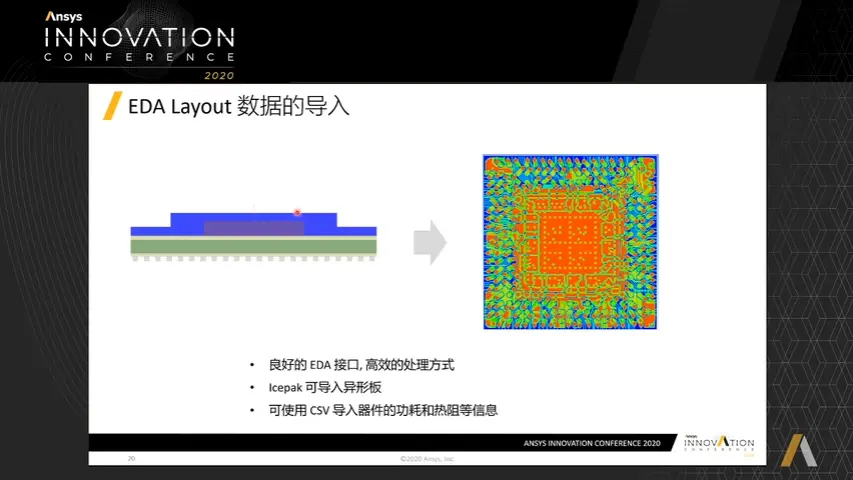
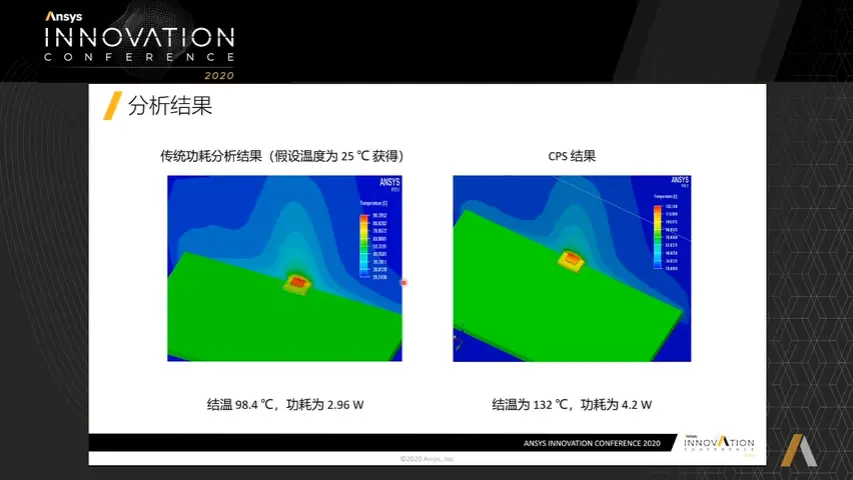
武汉格发信息技术有限公司,格发许可优化管理系统可以帮你评估贵公司软件许可的真实需求,再低成本合规性管理软件许可,帮助贵司提高软件投资回报率,为软件采购、使用提供科学决策依据。支持的软件有: CAD,CAE,PDM,PLM,Catia,Ugnx, AutoCAD, Pro/E, Solidworks ,Hyperworks, Protel,CAXA,OpenWorks LandMark,MATLAB,Enovia,Winchill,TeamCenter,MathCAD,Ansys, Abaqus,ls-dyna, Fluent, MSC,Bentley,License,UG,ug,catia,Dassault Systèmes,AutoDesk,Altair,autocad,PTC,SolidWorks,Ansys,Siemens PLM Software,Paradigm,Mathworks,Borland,AVEVA,ESRI,hP,Solibri,Progman,Leica,Cadence,IBM,SIMULIA,Citrix,Sybase,Schlumberger,MSC Products...